
- 超高真空ワイドエリアエバポレーター(1源タイプ) AEV-HR1
|
・低レート〜高レートを安定して蒸着する事により、高融点材料の蒸着も可能です。 ・試料移動機構が標準装備され、長時間の蒸着が可能です。 ・内蔵のフラックスモニターと専用コントローラーとの組み合わせにより蒸着速度を管理することが可能です。 ・ロッド状材料が蒸着中に減少しても、試料移動機構により超高真空を破ることなく最適な蒸着試料位置への移動が可能です。 ・オプションにてルツボ対応も可(ご相談ください) ・PDFカタログはこちら→超高真空ワイドエリアエバポレーター(PDF) |
 |
| 仕様 Specification | ||
| ワーキングディスタンス Working Distance | 〜250mm | 〜250mm |
| 蒸着エリア Evaporation Area |
Ø80〜Ø140mm程度(ワーキングディスタンスによる) | Beam adjustment mechanism Ø80-Ø140mm (depends on WD) |
| シャッター Shutter | 手動シャッター | Manual shutter |
| 水冷 Water-Cooled | 水冷却/30℃以下、5L/min以上 | Water-cooled shroud (cooling water: < 30 degrees C; 5L/min) |
| 試料 Sample | ロッドまたはルツボ(オプション) | Wire; Rod (high melting point material); evaporation from the crucible (optional) |
| 蒸発レート Deposition Rate | 0.1原子層/min 〜 0.5Å/s ※試料による | Standard evaporation rate: 0.1layers/min 〜 0.5Å/s |
| 蒸着モニター Flux Monitor | 蒸着制御用内蔵フラックスモニター (AEV-3P-600にて、蒸発レートコントロールが可能) | lntrnal flux monitor for deposition control (for each source): The dedicated power supply unit AEV-3P-600, allows evaporation rate control |
| ロッド移動 Sample Movement | 中空型直線移動機構(S=30mm)(中空型直線移動機構下部のICF34フランジを通して蒸着材交換) | Linear motion feedthrough to locate the deposition sample (stroke = 30mm) Sample replacement through the ICF34 flange |
| 取付フランジ Mounting |
ICF114-FH ※取付ポートの内径はØ55mm以上必要 ※シャッターオープン時の有効内径は Ø58mm以上必要 |
Mountable on ICF114 flange (I.D. (internal diameter) must be Ø55mm or larger) (Range of Motion: Ø58 mm (Shutter Open)) |
| ベーキング温度 Fully Bakeable | 200℃ Max | 200 degrees C Max |
| ロッド材寸法 Rod Sample | Ø4mm or Ø6mm x L40mm | Ø4mm or Ø6mm x L40mm |
- 超高真空ワイドエリアエバポレーター(3源タイプ) AEV-HR3
|
・AEV-HR-1と同じ蒸発源をICF152に3源搭載したモデルになります。 ・3源全てが独立しているので、3源同時蒸着が可能です。また、試料移動機構により、長期間超高真空を破ることなく実験を行うことができます。 ・ワーキングディスタンス200mmにて1インチの成膜分布問題無しを確認 ・オプションにてルツボ対応も可(ご相談ください) ・PDFカタログはこちら→超高真空ワイドエリアエバポレーター(PDF) |
 |


| 仕様 Specification | ||
| ワーキングディスタンス Working Distance | 〜250mm | 〜250mm |
| 蒸着エリア Evaporation Area |
Ø80〜Ø140mm程度(ワーキングディスタンスによる) | Beam adjustment mechanism Ø80-Ø140mm (depends on WD) |
| シャッター Shutter | 手動シャッター | Manual shutter |
| 水冷 Water-Cooled | 水冷却/30℃以下、5L/min以上 | Water-cooled shroud (cooling water: < 30 degrees C; 5L/min) |
| 温度範囲 Temperature Range | 〜3300℃ | up to 3300 degrees C |
| 試料 Sample | ロッドまたはルツボ(オプション) | Wire; Rod (high melting point material) |
| 蒸発レート Deposition Rate | 0.1原子層/min 〜 0.5Å/s ※試料による | Standard evaporation rate: 0.1layers/min 〜 0.5Å/s |
| 蒸着モニター Flux Monitor | 蒸着制御用内蔵フラックスモニター (AEV-3P-600にて、蒸発レートコントロールが可能) | lntrnal flux monitor for deposition control (for each source): The dedicated power supply unit AEV-3P-600, allows evaporation rate control |
| ロッド移動 Sample Movement | 中空型直線移動機構(S=30mm)(中空型直線移動機構下部のICF34フランジを通して蒸着材交換) | Linear motion feedthrough to locate the deposition sample (stroke = 30mm) Sample replacement through the ICF34 flange |
| 取付フランジ Mounting |
ICF152-FH ※取付ポートの内径はØ114.3mm以上必要 ※シャッターオープン時の有効内径は Ø180mm以上必要 |
Mountable on ICF152 flange (I.D. (internal diameter) must be Ø114.3 or larger) (Range of Motion: Ø180 mm (Shutter Open)) |
| ベーキング温度 Fully Bakeable | 200℃ Max | 200 degrees C Max |
| ロッド材寸法 Rod Sample | Ø4mm or Ø6mm x L40mm | Ø4mm or Ø6mm x L40mm |
- 超高真空タイプ1源エバポレーター AEV-11
| ・単原子層や薄膜の作製を目的に設計されており、ロッド状材料をEB加熱により高純度の蒸着を行うことが可能です。 ・内蔵のフラックスモニターと専用コントローラーとの組み合わせにより蒸着速度を管理することが可能です。 ・ロッド状材料が蒸着中に減少しても、試料移動機構により超高真空を破ることなく最適な蒸着試料位置への移動が可能です。 |
 |
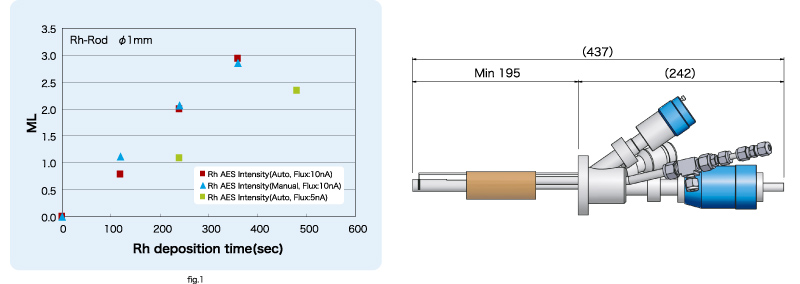
| 仕様 Specification | ||
| ワーキングディスタンス Working Distance | 150mm | 150mm |
| 蒸着エリア Evaporation Area | Ø8〜Ø20mm程度 (アバーチャー入替にて選択可能) |
Beam adjustment mechanism Ø8-Ø20mm (at WD = 150mm) |
| シャッター Shutter | 手動シャッター | Manual shutter |
| 水冷 Water-Cooled | 水冷却/30℃以下、0.5L/min以上 | Water-cooled shroud (cooling water: < 30 degrees C; 0.5L/min) |
| 温度範囲 Temperature Range | 〜3300℃ | up to 3300 degrees C |
| 試料 Sample | ロッドまたはルツボ(オプション) | Wire; Rod (high melting point material); evaporation from the crucible (optional) |
| 蒸発速度 Deposition Rate | 数原子層/min | Standard evaporation rate: a few layers/min |
| 蒸着モニター Flux Monitor | 蒸着制御用内蔵フラックスモニター (AEV-1P-300にて、蒸発レートコントロールが可能) | lntrnal flux monitor for deposition control (for each source): The dedicated power supply unit AEV-1P-300, allows evaporation rate control |
| ロッド移動 Sample Movement | 中空型直線移動機構(S=30mm)(中空型直線移動機構下部のICF34フランジを通して蒸着材交換) | Linear motion feedthrough to locate the deposition sample (stroke = 30mm) Sample replacement through the ICF34 flange |
| 取付フランジ Mounting |
ICF70-FH ※取付ポートの内径はØ35mm以上必要 |
Mountable on ICF70 flange (I.D. (internal diameter) must be Ø35 or larger) |
| ベーキング温度 Fully Bakeable | 200℃ Max | 200 degrees C Max |
| ロッド材寸法 Rod Sample | Ø2mm x L40mm | Ø2mm x L40mm |
- 超高真空タイプ3源エバポレーター AEV-3
| ・AEV-11と同じ蒸発源をICF70に3源搭載したモデルになります。 ・3源全てが独立しているので、3源同時蒸着が可能です。また、材料移動機構により、長期間超高真空を破ることなく実験を行うことができます。 |
 |

| 仕様 Specification | ||
| ワーキングディスタンス Working Distance | 120mm〜170mm | 120mm〜170mm |
| 蒸着エリア Evaporation Area | Ø15〜Ø20mm程度 (ワーキングディスタンスによる) |
Beam adjustment mechanism Ø15〜Ø20mm |
| シャッター Shutter | 手動シャッター | Manual shutter |
| 水冷 Water-Cooled | 冷却水/30℃以下、1.0L/min以上 | Water-cooled shroud (cooling water : < 30 degrees C; 1.0L/min) |
| 温度範囲 Temperature Range | 〜3300℃ | Temperature: up to 3300 degrees C |
| 試料 Sample |
ロッドまたはルツボ(オプション) | Wire; Rod (high melting point material); evaporation from the crucible (optional) |
| 蒸発速度 Deposition Rate | 数原子層/min | Standard evaporation rate: a few layers/min |
| 蒸着モニター Flux Monitor | 蒸着制御用内蔵フラックスモニター(各ソースに対しAEV-1P-300にて蒸発レートコントロールが可能) | lnterna flux monitor for deposition control (dedicated power supply unit, AEV-1P-300 allows evaporation rate control) |
| ロッド移動 Sample Movement | 中空型直線移動機構(S=30mm)(中空型直線移動機構下部のICF34フランジを通して蒸着材交換) | Linear motion feedthrough to locate the deposition sample (stroke = 30mm) Sample replacement through the ICF34 flange |
| 取付フランジ Mounting |
ICF70-FH ※取付ポートの内径はØ38mm以上必要、 シャッター可動範囲Ø72 |
Mountable on ICF70 flange (I.D. (internal diameter) must be Ø38 or larger; Shutter movable range Ø72) |
| ベーキング温度 Fully Bakeable | 200℃ Max | 200 degrees C Max |
| ロッド材寸法 Rod Sample | Ø2mm x L40mm | Ø2mm x L40mm |
- エバポレーター専用コントローラー AEV-1P-300、AEV-3P-600
| AEV-1P-300はAEV-11,AEV-3専用に設計されたコントローラーです。AEV-11,AEV-3と組み合わせて使用することにより、マニュアル操作によるコントロールはもちろん、フラックスモニターを使ったレートコントロールにより自動制御が可能です。 制御レンジは7レンジ構成で、レートコントロールが幅広く対応できるようになっております。尚、フラックスモニターのEXT出力をモニターすることにより蒸着条件の記録が可能です。 ガン本体にある温度モニターを利用し、安全回路を設けてあることにより、安心してご使用いただけます。 また、AEV-HR1とAEV-HR3にはHV出力の違うAEV-3P-600をご利用ください。 |
 |
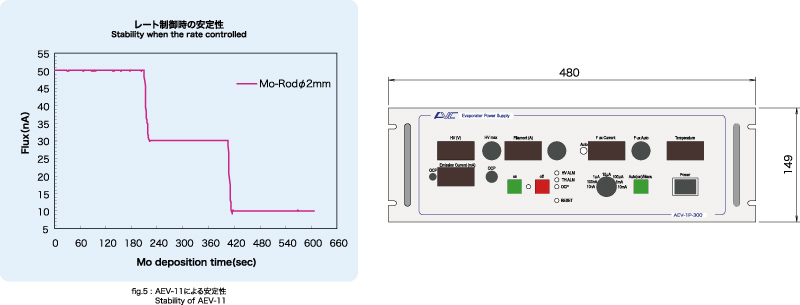
| 仕様 Specification | ||
| サイズ Dimensions | 480(W)x149(H)x500(D) ※取付け奥行き 600 | 480(W) x 149(H) x 500(D) requires 600(D) for installation |
| 入力電源 Power Supply | AC 85V〜265V / 5A | AC 85V - 265V / 5A |
| フィラメント電流 Filament Output | 0〜5A | 0 - 5A |
| HV出力 HV Output | AEV-1P-300:0〜1000V at 300mA AEV-3P-600:0〜3000V at 200mA | AEV-1P-300:0〜1000V at 300mA AEV-3P-600:0〜3000V at 200mA |
| フラックスモニター入力 Flux Monitor Input | 0〜10nAから0〜10mA (7レンジ切り替え式) | 7 ranges (10nA - 10mA) manual switch feature |
| フラックスモニター出力 Flux Monitor Output | 0〜10V | 0 - 10V |
| インターロック入力 Interlock External | ドライ接点 | No-voltage contact |
| 内部インターロック Interlock Internal | 冷却部温度モニター HV 異常放 電設定値によるエミッションオーバーラン防止 | Temperature monitor to avoid excessive high temperature |
| フラックスコントロール Flux Control |
自動/手動切替え | Auto |
- エバポレーター専用セレクター AEV-3SEL-1
|
AEV-3SEL-1はAEV専用に設計されたセレクターです。3チャンネルまで切り替えが可能です。 ケーブルの抜き差しを行うことなく、手軽にガンの切り替えが行えます。 複数のガンを使用する際に、ケーブルの取り回しを気にすることなく効率よく作業できます。 |
 |
| 仕様 Specification | ||
| サイズ Dimensions | 480(W)x100(H)x450(D) ※取付け奥行き 600 | 480(W) x 100(H) x 450(D) requires 600(D) for installation |
| 入力電源 Power Supply | AC 85V〜265V / 5A | AC 85V - 265V / 5A |
| チャンネル Channel | 3Ch | 3Ch |
- 蒸着エリア可変タイプ有機 エバポレーター AEV-OD
| AEV-ODは、結晶性の高い有機薄膜の成膜を目的に設計されております。有機材料をルツボから低レートで安定した蒸発を行うことが可能です。また、フライトチューブの採用により蒸発した有機材料を拡散・付着させることなく、基板付近まで到達させて蒸着することが可能になりました。その為、少量の有機材料を効率よく蒸着することが出来ます。 有機材料の飛散を最小限に抑えられますので、既存の超高真空システムに容易に導入することが可能になりました。

|
 |
- AEV-OD用コントローラ AEV-ODP
|
AEV-ODPは、AEV-OD用に設計されたコントローラです。 フライトチューブ温度を80℃ 〜 350℃で4ch設定可能です。

|